



特性
搭載光譜分析軟體,可同時測量多層膜的膜厚(通常為3層),以及測量光學定數(n,k)。
可設定詳細參數以適用於各類膜,用途更為廣泛。
感光元件採用線性圖像傳感元件,實現高速測量。
通過設定高感度高分解偵測頭(選配),氧化膜可測量至70μm,同時配合使用100倍接物鏡(可觀察至點半徑0.75μm)。
可簡單設定適合於觀察測量特殊膜的程式。
通過選配可實現多種應用(磁場偵測頭,FPD,材料研究等)
最新系統應用於Windows7程式
測量原理
下圖為光學干涉法薄膜測厚儀的原理。
通過接物鏡向參照測量物件射入垂直光線,其反射光線將被分散為各種波長。採集各波長的資料以建立資料庫,形成測量模型。每當測量時,將測量結果的光譜與資料庫的光譜進行對比,取出最近似的資料作為測量 結果輸出。(曲線擬合法)
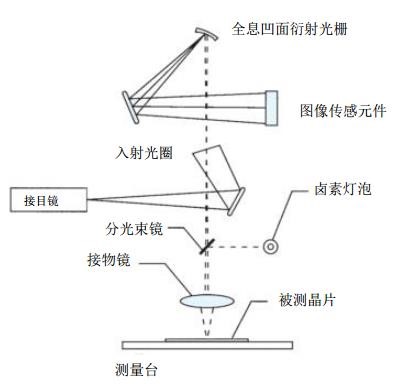
可選配件
· 高感度高分解偵測頭(Model 3100)
· USB攝像頭
· 防震台(用於高倍率)
基本配置
測量程式 | 任何基板材質的多層膜(一般為3層) |
可測量的波長範圍 | 380~800nm |
可測量的膜厚範圍 | 100Å~30μm |
測量重現精度 | 2Å[同一點15回測定時1δ] |
測定時間 | 0.1~25秒/1點 |
接物鏡 | 5倍(φ50μm) |
接物鏡(選配) | 10倍(φ50μm) 50倍(φ5μm) |



